| 项目 | 参数 |
|---|---|
| 键合工艺适用范围 | TCB-NCP、C2与C4工艺、FO-WLP工艺 |
| 键合精度 | ±1.5 μm |
| 产能 (UPH) | 双头双工位,600片 |
| 键合压力 | 2–490N |
| 键合工具设定温度 | RT–450℃ ±5℃(1℃ 步进,脉冲加热) |
| 邦头升温速率 | >Max100℃/sec |
| 邦头冷却速率 | Max80℃/sec |
| 键合平台设定温度 | RT–200 (1℃ 步进) |
| 芯片尺寸 | 最小~最大:1–22mm,厚度0.02–0.7mm |
| 环框晶圆尺寸 | Φ300mm |
| 承载晶圆尺寸 | Φ300mm |
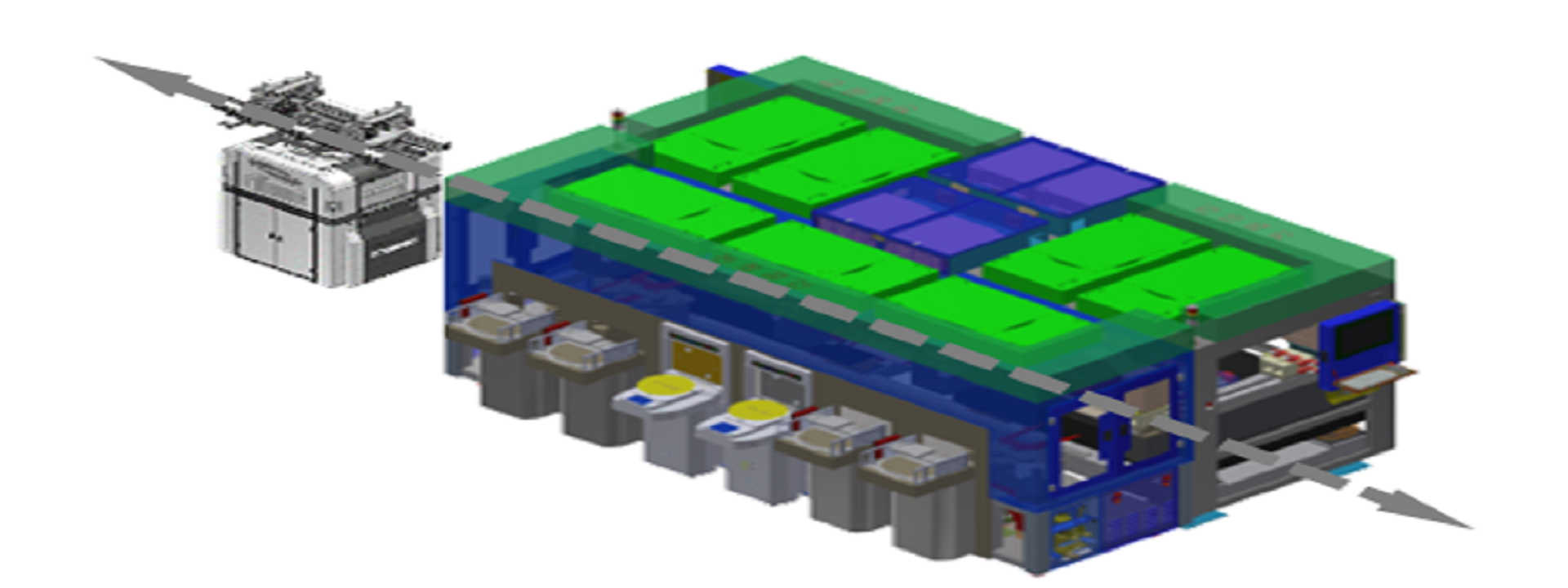
TCB热压键合机
用于2.5D/3D C2S(Chip to Substrate)及C2W(Chip to Wafer)封装的核心设备 双系统结构的热压方式超精密键合设备,实现生产效率最大化与设备小型化的系统 适用于12英寸晶圆 键合精度±1.5μm